




根据密封方式的不一样,MFX分为开放管和封闭管两种。封闭管MFX中,阴极与阳极/靶都封闭在真空管内;使用时无需抽真空,无需维护,但也无法更换阴极和阳极/靶。开放管MFX则带有真空泵、真空阀,像排气设备一样。阴极和阳极/靶都可以更换。
2024/06
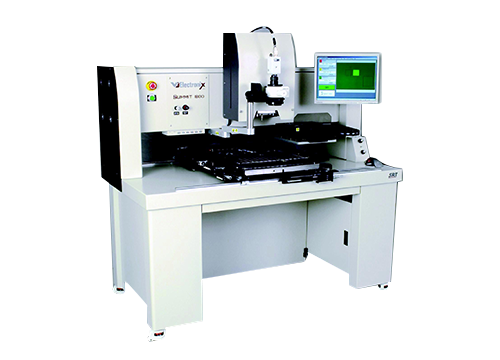
x射线无损检测中X射线是一种高能射线,对人体有害。因为有地球大气层的保护,宇宙中的X射线都已被隔绝,自然的环境中则鲜有它的存在。总的来看,X射线穿透力极强,但物质对它的吸收程度却各不相同。利用这一特性,X射线可以被用来探知物体内部的结构形状甚至成份。如今它已被我们广泛应用于医疗影像、安检、工业无损检测中。
2024/06

伟杰光源公司作为X射线源解决方案供应商,在工业X射线应用领域具有丰富经验。我们的创新潜力、精进技术、灵活而高效的业务模式使其成为客户优选的工程合作伙伴。从75kV – 600kV范围的固定式X射线源,到便携式和移动式射线机,伟杰光源凭借卓越的技术、精确的瑞士工艺、高性能、高可靠性的X射线管和高压发生器、完善的本地化售后服务获得了良好的声誉,成为整机集成客户业务不断发展的有力保障。
2024/06

X射线透过被检查物体后,把不同强度的射线,再投射在涂有荧光物质的荧光屏上,激发出不同强度的荧光而得到物体的影像。如果我们能直接从荧光屏上观察缺陷影像,就称为X射线荧光屏观察法。
2024/06

射线检测探伤中X射线机是X射线探伤的主要设备。国产X射线探伤机已系列化,分为移动式和便携式两大类。移动式X光检测设备一般检测对象体积较大,而便携式X光检测设备一般检测对象体积较小。比如:铝合金铸件射线检测,钛合金铸件射线检测,发动机叶片探伤,发动机导管探伤等。
2024/06

X射线能在无损检测技术中得到广泛应用的主要原因是:X射线探伤设备是指利用X射线能够穿透金属材料,并由于材料对射线的吸收和散射作用的不同,从而使胶片感光不一样,于是在底片上形成黑度不同的影像,据此来判断材料内部缺陷情况的一种检验方法。
2024/06
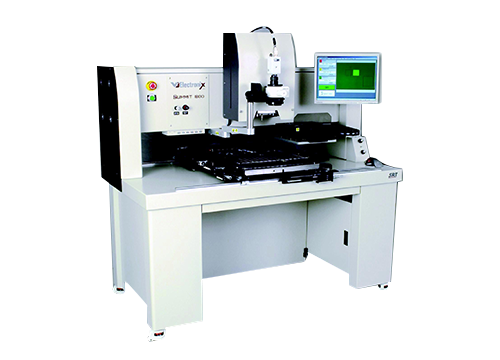
伟杰光源制造便携式X射线源,是21世纪X射线应力分析测试技术成果,适应各种规格尺寸部件大规模应力分析测试需要,同时可测量残余应力和奥氏体,具有较高的分析测试灵敏度,测量速度和可靠性。
2024/06

BGA的封装方式不同使用BGA返修台贴片元件的方法也不一样的,我们常见的BGA封装方式有:BGA:BallGridArra(球栅阵列式封装)、PBGA(塑料封装)、CBGA(陶瓷封装)、TBGA(载带状封装)、CSP:ChipScalePacka(芯片尺寸封装)、QFP:四边扁平封装,一般封装间距为0.3mm和0.4mm。在这么多种封装方式里最常见的是BGA球栅阵列式封装。
2024/06

从伟杰科技了解到:BGA返修台的组成并不复杂,BGA返修台其实都自带温度设置系统和光学对位功能,结构组成差不多的,区别其实就是在返修精度上面。BGA返修台是一款用来返修不良BGA芯片的设备,能够应对焊接BGA芯片时出现的空焊、假焊、虚焊、连锡等问题。
2024/06

精密光学BGA返修台是一款具备高清光学对位及智能控制,温度控制十分稳定,红外温区可移动,方便维修大型和不规则PCBA。精密光学BGA返修台设备特点:
2024/06